-
Group III nitride semiconductors, such as GaN, AlN, and InN, are an important class of compound semiconductor material, and have attracted much attention, because of their unique physicochemical properties. These semiconductors possess excellent characteristics, such as wide direct bandgap, high breakdown field strength, high electron mobility, and good stability, and thus are called third-generation semiconductors. Their alloy materials can adjust their bandgaps by changing the type or proportion of group III elements, covering a wide wavelength range from near-ultraviolet to infrared, thereby achieving wavelength selectivity in optoelectronic devices. Atomic layer deposition (ALD) is a unique technique that produces high-quality group III nitride films at low temperatures. The ALD has become an important method of preparing group III nitrides and their alloys. The alloy composition can be easily controlled by adjusting the ALD cycle ratio. This review highlights recent work on the growth and application of group III nitride semiconductors and their alloys by using ALD. The work is summarized according to similarities so as to make it easier to understand the progress and focus of related research. Firstly, this review summarizes binary nitrides with a focus on their mechanism and application. In the section on mechanism investigation, the review categorizes and summarizes the effects of ALD precursor material, substrate, temperature, ALD type, and other conditions on film quality. This demonstrates the effects of different conditions on film growth behavior and quality. The section on application exploration primarily introduces the use of group III nitride films in various devices through ALD, analyzes the enhancing effects of group III nitrides on these devices, and explores the underlying mechanisms. Additionally, this section discusses the growth of group III nitride alloys through ALD, summarizing different deposition methods and conditions. Regarding the ALD growth of group III nitride semiconductors, there is more research on the ALD growth of AlN and GaN, and less research on InN and its alloys. Additionally, there is less research on the ALD growth of GaN for applications, as it is still in the exploratory stage, while there is more research on the ALD growth of AlN for applications. Finally, this review points out the prospects and challenges of ALD in preparation of group III nitride semiconductors and their alloys.
-
Keywords:
- atomic layer deposition /
- nitride semiconductor /
- thin films growth
[1] Lakshmi E 1981 Thin Solid Films 83 L137
 Google Scholar
Google Scholar
[2] Porowski S 1997 Mater. Sci. Eng. B 44 407
 Google Scholar
Google Scholar
[3] Pearton S J, Ren F, Zhang A P, Lee K P 2000 Mat. Sci. Eng. R 30 55
 Google Scholar
Google Scholar
[4] Glavin N R, Chabak K D, Heller E R, Moore E A, Prusnick T A, Maruyama B, Walker Jr D E, Dorsey D L, Paduano Q, Snure M 2017 Adv. Mate. 29 1701838
 Google Scholar
Google Scholar
[5] Mizutani H, Ishikawa R, Honjo K 2017 IEEE Compound Semiconductor Integrated Circuit Symposium (CSICS) Miami, FL, USA, October 22–25, 2017 pp1–4
[6] Bentini A, Palombini D, Rampazzo D 2017 12th European Microwave Integrated Circuits Conference (EuMIC) Nuremberg, Germany, October 8–10, 2017 pp125–128
[7] Margomenos A, Kurdoghlian A, Micovic M, Shinohara K, Moyer H, Regan D C, Grabar R M, McGuire C, Wetzel M D, Chow D H 2014 IEEE Compound Semiconductor Integrated Circuit Symposium (CSICS) La Jolla, CA, USA, October 19–22, 2014 pp1–4
[8] Bui H V, Wiggers F B, Gupta A, Nguyen M D, Aarnink A A I, Jong M P D, Kovalgin A Y 2015 J. Vac. Sci. Technol. A 33 01A111
[9] Shur M 2019 Solid-State Electron. 155 65
 Google Scholar
Google Scholar
[10] Chabak K D, Walker D E, Johnson M R, Crespo A, Dabiran A M, Smith D J, Wowchak A M, Tetlak S K, Kossler M, Gillespie J K, Fitch R C, Trejo M 2011 IEEE Electr. Device Lett. 32 1677
 Google Scholar
Google Scholar
[11] Abd Rahman M N, Shuhaimi A, Abdul Khudus M I M, Anuar A, Zainorin M Z, Talik N A, Chanlek N, Abd Majid W H 2021 J. Electron. Mater. 50 2313
 Google Scholar
Google Scholar
[12] Slack G A, Tanzilli R A, Pohl R O, Vandersande J W 1987 J. Phys. Chem. Solids 48 641
 Google Scholar
Google Scholar
[13] Zhang Z P, Gao B, Fang Z, Wang X P, Tang Y Z, Sohn J, Wong H S P, Wong S S, Lo G Q 2015 IEEE Electr. Device Lett. 36 29
 Google Scholar
Google Scholar
[14] Eisele H, Schuppang J, Schnedler M, Duchamp M, Nenstiel C, Portz V, Kure T, Bügler M, Lenz A, Dähne M, Hoffmann A, Gwo S, Choi S, Speck J S, Dunin-Borkowski R E, Ebert P 2016 Phys. Rev. B 94 245201
 Google Scholar
Google Scholar
[15] Bhatta R P, Thoms B D, Alevli M, Dietz N 2007 Surf. Sci. 601 L120
 Google Scholar
Google Scholar
[16] Wang S L, Liu H X, Chen Q, Zhang H L 2016 J. Mater. Sci. Mater. El. 27 11353
 Google Scholar
Google Scholar
[17] Wu J, Walukiewicz W, Yu K M, III J W A, Haller E E, Lu H, Schaff W J, Saito Y, Nanishi Y 2002 Appl. Phys. Lett. 80 3967
 Google Scholar
Google Scholar
[18] Ciorga M, Bryja L, Misiewicz J, Paszkiewicz R, Korbutowicz R, Panek M, Paszkiewicz B, Tlaczala M 1999 Mater. Sci. Eng. B 59 16
 Google Scholar
Google Scholar
[19] Kalaitzakis F G, Konstantinidis G, Sygellou L, Kennou S, Ladas S, Pelekanos N T 2012 Microelectron. Eng. 90 115
 Google Scholar
Google Scholar
[20] Nakada Y, Aksenov I, Okumura H 1998 Appl. Phys. Lett. 73 827
 Google Scholar
Google Scholar
[21] Hemmingsson C, Paskov P P, Pozina G, Heuken M, Schineller B, Monemar B 2007 J. Cryst. Growth 300 32
 Google Scholar
Google Scholar
[22] Zhang J X, Qu Y, Chen Y Z, Uddin A, Yuan S 2005 J. Cryst. Growth 282 137
 Google Scholar
Google Scholar
[23] Etzkorn E V, Clarke D R 2004 Int. J. High Speed Electron. Syst. 14 63
 Google Scholar
Google Scholar
[24] Ozturk M K, Arslan E, Kars I, Ozcelik S, Ozbay E 2013 Mat. Sci. Semicond. Process. 16 83
 Google Scholar
Google Scholar
[25] Kizir S, Haider A, Biyikli N 2016 J. Vac. Sci. Technol. A 34 041511
 Google Scholar
Google Scholar
[26] Ozgit C, Donmez I, Alevli M, Biyikli N 2012 J. Vac. Sci. Technol. A 30 01A124
 Google Scholar
Google Scholar
[27] Maeng W J, Choi D W, Park J, Park J S 2015 J. Alloys Compd. 649 216
 Google Scholar
Google Scholar
[28] Shih H Y, Lin M C, Chen L Y, Chen M J 2014 Nanotechnology 26 014002
 Google Scholar
Google Scholar
[29] Lee S H, Kwon J D, Ahn J H, Park J S 2017 Ceram. Int. 43 6580
 Google Scholar
Google Scholar
[30] Asif Khan M, Skogman R A, Van Hove J M, Olson D T, Kuznia J N 1992 Appl. Phys. Lett. 60 1366
 Google Scholar
Google Scholar
[31] Karam N H, Parodos T, Colter P, McNulty D, Rowland W, Schetzina J, El-Masry N, Bedair S M 1995 Appl. Phys. Lett. 67 94
 Google Scholar
Google Scholar
[32] Liu S J, He Y F, Wei H Y, Qiu P, Song Y M, An Y L, Rehman A, Peng M Z, Zheng X H 2019 Chin. Phys. B 28 026801
 Google Scholar
Google Scholar
[33] Liu S J, Zhao G, He Y F, Wei H Y, Li Y F, Qu P, Song Y M, An Y L, Wang X Y, Wang X X, Cheng J D, Peng M Z, Zheng X H 2019 ACS Appl. Mater. Interfaces 11 35382
 Google Scholar
Google Scholar
[34] Liu S J, Zhao G, He Y F, Li Y F, Wei H Y, Qiu P, Wang X Y, Wang X X, Cheng J D, Peng M Z, Zaera F, Zheng X H 2020 Appl. Phys. Lett. 116 211601
 Google Scholar
Google Scholar
[35] Ozgit-Akgun C, Donmez I, Biyikli N 2013 ECS Trans. 58 289
 Google Scholar
Google Scholar
[36] Gungor N, Alevli M 2018 J. Vac. Sci. Technol. A. 36 021514
 Google Scholar
Google Scholar
[37] Shukla D, Mohammad A, Ilhom S, Willis B G, Okyay A K, Biyikli N 2021 J. Vac. Sci. Technol. A. 39 022406
 Google Scholar
Google Scholar
[38] Gungor N, Alevli M 2019 J. Vac. Sci. Technol. A. 37 050901
 Google Scholar
Google Scholar
[39] Deminskyi P, Hsu C W, Bakhit B, Rouf P, Pedersen H 2021 J. Vac. Sci. Technol. A. 39 012411
 Google Scholar
Google Scholar
[40] Lee W H, Yin Y T, Cheng P H, Shyue J J, Shiojiri M, Lin H C, Chen M J 2018 ACS Sustain. Chem. Eng. 7 487
[41] Rouf P, O’Brien N J, Buttera S C, Martinovic I, Bakhit B, Martinsson E, Palisaitis J, Hsu C W, Pedersen H 2020 J. Mater. Chem. C 8 8457
 Google Scholar
Google Scholar
[42] Rouf P, Samii R, Rönnby K, Bakhit B, Buttera S C, Martinovic I, Ojamäe L, Hsu C W, Palisaitis J, Kessler V, Pedersen H, O’Brien N J 2021 Chem. Mater. 33 3266
 Google Scholar
Google Scholar
[43] He Y F, Li M L, Liu S J, Wei H Y, Ye H Y, Song Y M, Qiu P, An Y L, Peng M Z, Zheng X H 2019 Acta Metall Sin-Engl 32 1530
 Google Scholar
Google Scholar
[44] He Y F, Song Y M, Wei H, Qiu P, Liu H, Zhu X, Tian F, Peng M Z, Zheng X H 2023 Appl. Phys. Lett. 122 041602
 Google Scholar
Google Scholar
[45] He Y F, Si Z, Shi Y A, Wei H, Peng M Z, Zheng X H 2023 Mater. Lett. 350 134801
 Google Scholar
Google Scholar
[46] He Y F, Li M, Wei H, Song Y M, Qiu P, Peng M Z, Zheng X H 2021 Appl. Surf. Sci. 566 150684
 Google Scholar
Google Scholar
[47] Song Y M, He Y F, Li Y F, Wei H Y, Qiu P, Huang Q M, He Z Q, Die J H, Peng M Z, Zheng X H 2021 Cryst. Growth Des. 21 1778
 Google Scholar
Google Scholar
[48] Song Y M, Li Y F, He Y F, Wei H Y, Qiu P, Hu X T, Su Z L, Jiang Y, Peng M Z, Zheng X H 2022 ACS Appl. Mater. Interfaces 14 16866
 Google Scholar
Google Scholar
[49] Qiu P, Wei H Y, An Y L, Wu Q, Du W, Jiang Z, Zhou L, Gao C, Liu S J, He Y F, Song Y M, Peng M Z, Zheng X H 2020 Ceram. Int. 46 5765
 Google Scholar
Google Scholar
[50] Wei H Y, Wu J, Qiu P, Liu S J, He Y F, Peng M Z, Li D, Meng Q, Zaera F, Zheng X H 2019 J. Mater. Chem. A 7 25347
 Google Scholar
Google Scholar
[51] Qiu P, Wei H Y, Huang Q, Yu M, Hu Y, Zhu X, Liu H, Zheng X H 2023 Ceram. Int. 49 22030
 Google Scholar
Google Scholar
[52] Lee Y J, Kang S W 2004 Thin Solid Films 446 227
 Google Scholar
Google Scholar
[53] Liu S J, Peng M Z, Hou C, He Y F, Li M, Zheng X H 2017 Nanoscale Res. Lett. 12 279
 Google Scholar
Google Scholar
[54] Liu S J, Li Y F, Tao J, Tang R, Zheng X H 2023 Crystals 13 910
[55] Zhang X Y, Peng D C, Han J, Ren F B, Jiang S C, Tseng M C, Ruan Y J, Zuo J, Wu W Y, Wuu D S, Huang C J, Lien S Y, Zhu W Z 2023 Surf. Interface 36 102589
 Google Scholar
Google Scholar
[56] Schilirò E, Giannazzo F, Bongiorno C, Di Franco S, Greco G, Roccaforte F, Prystawko P, Kruszewski P, Leszczyński M, Krysko M, Michon A, Cordier Y, Cora I, Pecz B, Gargouri H, Nigro R L 2019 Mat. Sci. Semicond. Process. 97 35
 Google Scholar
Google Scholar
[57] Gungor N, Alevli M 2022 J. Vac. Sci. Technol. A 40 022404
 Google Scholar
Google Scholar
[58] Strnad N A, Sarney W L, Rayner G B, Benoit R R, Fox G R, Rudy R Q, Larrabee T J, Shallenberger J, Pulskamp J S 2022 J. Vac. Sci. Technol. A 40 042403
 Google Scholar
Google Scholar
[59] Tian L, Ponton S, Benz M, Crisci A, Reboud R, Giusti G, Volpi F, Rapenne L, Vallée C, Pons M, Mantoux A, Jiménez C, Blanquet E 2018 Surf. Coat. Technol. 347 181
 Google Scholar
Google Scholar
[60] Kao W C, Lee W H, Yi S H, Shen T H, Lin H C, Chen M J 2019 RSC Adv. 9 12226
 Google Scholar
Google Scholar
[61] Seppanen H, Kim I, Etula J, Ubyivovk E, Bouravleuv A, Lipsanen H 2019 Materials 12 610
[62] Kot M, Henkel K, Naumann F, Gargouri H, Lupina L, Wilker V, Kus P, Poz´arowska E, Garain S, Rouissi Z, Schmeißer D 2019 J. Vac. Sci. Technol. A 37 020913
[63] Dallaev R, Sobola D, Tofel P, Škvarenina Ľ, Sedlák P 2020 Coatings 10 954
[64] Legallais M, Mehdi H, David S, Bassani F, Labau S, Pelissier B, Baron T, Martinez E, Ghibaudo G, Salem B 2020 ACS Appl. Mater. Interfaces 12 39870
 Google Scholar
Google Scholar
[65] Mohammad A, Shukla D, Ilhom S, Willis B, Johs B, Okyay A K, Biyikli N 2019 J. Vac. Sci. Technol. A 37 020927
 Google Scholar
Google Scholar
[66] Ilhom S, Shukla D, Mohammad A, Grasso J, Willis B, Biyikli N 2020 J. Vac. Sci. Technol. A 38 022405
 Google Scholar
Google Scholar
[67] Yun H J, Kim H, Choi B J 2020 Ceram. Int. 46 13372
 Google Scholar
Google Scholar
[68] Jung Y C, Hwang S M, Le D N, Kondusamy A L N, Mohan J, Kim S W, Kim J H, Lucero A T, Ravichandran A, Kim H S, Kim S J, Choi R, Ahn J, Alvarez D, Spiegelman J, Kim J 2020 Materials 13 3387
 Google Scholar
Google Scholar
[69] Parkhomenko R G, De Luca O, Kolodziejczyk L, Modin E, Rudolf P, Martinez Martinez D, Cunha L, Knez M 2021 Dalton Trans. 50 15062
 Google Scholar
Google Scholar
[70] Tiwari C, Dixit A 2021 Appl. Phys. A 127 862
[71] Liu X Y, Zhao S X, Zhang L Q, Huang H F, Shi J S, Zhang C M, Lu H L, Wang P F, Zhang D W 2015 Nanoscale Res. Lett. 10 109
 Google Scholar
Google Scholar
[72] Zhang L Q, Wang P F 2018 Jpn. J. Appl. Phys. 57 096502
 Google Scholar
Google Scholar
[73] Tzou A J, Chu K H, Lin I F, Ostreng E, Fang Y S, Wu X P, Wu B W, Shen C H, Shieh J M, Yeh W K, Chang C Y, Kuo H C 2017 Nanoscale Res. Lett. 12 315
 Google Scholar
Google Scholar
[74] Zhao S X, Liu X Y, Zhang L Q, Huang H F, Shi J S, Wang P F 2016 Nanoscale Res. Lett. 11 137
 Google Scholar
Google Scholar
[75] Kim K, Hua M, Liu D, Kim J, Chen K J, Ma Z 2018 Nano Energy 43 259
 Google Scholar
Google Scholar
[76] Chen S W H, Yang D R, You N J, Ho W C, Tzou J, Kuo H C, Shieh J M 2021 IEEE Trans. Nanotechnol. 20 489
 Google Scholar
Google Scholar
[77] Kim H, Kwon Y, Choi B J 2019 Thin Solid Films 670 41
 Google Scholar
Google Scholar
[78] Schiliro E, Giannazzo F, Di Franco S, Greco G, Fiorenza P, Roccaforte F, Prystawko P, Kruszewski P, Leszczynski M, Cora I, Pecz B, Fogarassy Z, Lo Nigro R 2021 Nanomaterials 11 3316
 Google Scholar
Google Scholar
[79] Kim H, Yun H J, Choi S, Choi B J 2020 Appl. Phys. A 126 449
 Google Scholar
Google Scholar
[80] Boris D R, Anderson V R, Nepal N, Johnson S D, Robinson Z R, Kozen A C, Eddy Jr. C R, Walton S G 2018 J. Vac. Sci. Technol. A 36 051503
 Google Scholar
Google Scholar
[81] Alevli M, Gungor N 2020 J. Vac. Sci. Technol. A 38 062407
 Google Scholar
Google Scholar
[82] Deminskyi P, Rouf P, Ivanov I G, Pedersen H 2019 J. Vac. Sci. Technol. A 37 020926
 Google Scholar
Google Scholar
[83] Ilhom S, Mohammad A, Shukla D, Grasso J, Willis B G, Okyay A K, Biyikli N 2020 RSC Adv. 10 27357
 Google Scholar
Google Scholar
[84] Woodward J M, Rosenberg S G, Boris D R, Johnson M J, Walton S G, Johnson S D, Robinson Z R, Nepal N, Ludwig K F, Hite J K, Eddy C R 2022 J. Vac. Sci. Technol. A 40 062405
 Google Scholar
Google Scholar
[85] Rouf P, O’Brien N J, Rönnby K, Samii R, Ivanov I G, Ojamäe L, Pedersen H 2019 J. Phys. Chem. C 123 25691
 Google Scholar
Google Scholar
[86] O’Brien N J, Rouf P, Samii R, Rönnby K, Buttera S C, Hsu C-W, Ivanov I G, Kessler V, Ojamäe L, Pedersen H 2020 Chem. Mater. 32 4481
 Google Scholar
Google Scholar
[87] Feng X C, Peng H, Gong J H, Wang W, Liu H, Quan Z J, Pan S, Wang L 2018 J. Appl. Phys. 124 243104
 Google Scholar
Google Scholar
[88] Peng H, Feng X C, Gong J H, Wang W, Liu H, Quan Z J, Pan S, Wang L 2018 Appl. Surf. Sci. 459 830
 Google Scholar
Google Scholar
[89] Woodward J M, Rosenberg S G, Kozen A C, Nepal N, Johnson S D, Wagenbach C, Rowley A H, Robinson Z R, Joress H, Ludwig K F, Eddy C R 2019 J. Vac. Sci. Technol. A 37 030901
 Google Scholar
Google Scholar
[90] Hsu C W, Deminskyi P, Martinovic I, Ivanov I G, Palisaitis J, Pedersen H 2020 Appl. Phys. Lett. 117 093101
 Google Scholar
Google Scholar
[91] An Y L, He Y F, Wei H Y, Liu S J, Li M, Song Y M, Qiu P, Rehman A, Zheng X H, Peng M Z 2019 Results Phys. 12 804
 Google Scholar
Google Scholar
[92] Ho I H, Stringfellow G B 1996 MRS Online Proc. Libr. 449 871
 Google Scholar
Google Scholar
[93] Surender S, Prabakaran K, Loganathan R, Pradeep S, Singh S, Baskar K 2017 J. Cryst. Growth 468 249
 Google Scholar
Google Scholar
[94] Huang Y 2012 J. Photon. Energy 2 028501
 Google Scholar
Google Scholar
[95] Haider A, Kizir S, Ozgit-Akgun C, Goldenberg E, Leghari S A, Okyay A K, Biyikli N 2015 J. Mater. Chem. C 3 9620
 Google Scholar
Google Scholar
[96] Rouf P, Palisaitis J, Bakhit B, O'Brien N J, Pedersen H 2021 J. Mater. Chem. C 9 13077
 Google Scholar
Google Scholar
[97] Ozgit-Akgun C, Goldenberg E, Okyay A K, Biyikli N 2014 J. Mater. Chem. C 2 2123
 Google Scholar
Google Scholar
[98] Nepal N, Anderson V R, Hite J K, Eddy C R 2015 Thin Solid Films 589 47
 Google Scholar
Google Scholar
[99] Portillo M C, Gallardo Hernández S, Panecatl Bernal Y, Martinez Velis I, Villanueva Cab J, Alcántara S, Alvarado J 2020 Opt. Mater. 108 110206
 Google Scholar
Google Scholar
[100] Choi S, Ansari A S, Yun H J, Kim H, Shong B, Choi B J 2021 J. Alloy. Compd. 854 157186
 Google Scholar
Google Scholar
[101] Kim H, Choi S, Choi B J 2020 Coatings 10 194
 Google Scholar
Google Scholar
[102] Kim H, Choi S, Choi B J 2020 Coatings 10 489
 Google Scholar
Google Scholar
[103] Kim H, Yun H J, Choi S, Choi B J 2020 Mater. Trans. 61 88
 Google Scholar
Google Scholar
-
图 2 (a)未经预处理的氮化镓薄膜的GIXRD曲线; (b) 预处理样品的XRD曲线; (c) (002) GaN峰的XRD ω扫描摇摆曲线; (d), (e)未经预处理和预处理的GaN/蓝宝石界面的HRTEM图像; (f) 预处理和未预处理的氮化镓的初始生长示意图; (g) 预处理的GaN薄膜的选区电子衍射图. 氮化镓是外延的, 存在$\left[ {1\bar 10} \right]$氮化镓//[100]蓝宝石平面排列; (h) 图(b)中黄色矩形所包围的GaN/蓝宝石界面区域的放大图[34]
Figure 2. (a) GIXRD patterns of the non-pretreated GaN thin film; (b) XRD patterns and (c) XRD ω-scan rocking curve of the (002) GaN peak of the pretreated sample; (d), (e) HRTEM images of the non-pretreated and pretreated GaN/sapphire interfaces, respectively; (f) the schematic diagram of the initial growth of pretreated and non-pretreated GaN; (g) selected area electron diffraction of the pretreated GaN thin film, GaN is epitaxial, with a $\left[ {1\bar 10} \right]$GaN//[100]sapphire plane alignment; (h) magnification of the GaN/sapphire interface region enclosed by the yellow rectangle in panel (b) [34].
图 3 实时测量的和平均原位椭圆光度法薄膜厚度数据显示, 即在衬底温度为(a) 120 , (b) 160, (c) 200和(d) 240 ℃时, TMG化学吸附和N2/H2/Ar等离子体辅助配体去除反应的等离子体射频功率相关性[37]
Figure 3. Real-time measured and averaged in situ ellipsometric film thickness data showing the plasma rf-power dependence of TMG chemisorption and N2/H2/Ar plasma-assisted ligand removal reactions at substrate temperatures of (a) 120, (b) 160, (c) 200 and (d) 240 ℃[37].
图 4 (a) H2O和(b) NH3预处理后的成核示意图. 蓝色区域、红色区域和a*分别代表完全羟基化状态、较高能量状态和反应性部位, 如离解的NH3[67]
Figure 4. Schematics of nucleation after (a) H2O and (b) NH3 pretreatment. The blue region, the red region and a* represent the fully hydroxylated state, a higher energy state, and a reactive site such as dissociated NH3, respectively[67].
图 5 (a) 用于InN的ALD研究的三种六价In(III)前体1—3; (b)前体3的改进的表面化学示意图, 显示与(c)前体2相比, 其iPr基团的立体和表面排斥力下降[85]
Figure 5. (a) Hexacoordinated In(III) precursors 1–3 used for the ALD study of InN; schematics of the suggested improved surface chemistry for (b) precursor 3, showing the decrease in steric and surface repulsion of its iPr groups in comparison to (c) precursor 2[85].
表 1 使用ALD沉积III族二元氮化物薄膜的生长条件概述, 包括薄膜生长和器件应用
Table 1. Overview of growth conditions for the deposition of group III binary nitride films using ALD, including film growth and device applications.
材料 金属前驱体 氮前驱体 沉积温度/ ℃ 沉积衬底 应用 ALD类型 等离子体功率/W 参考文献 GaN TEG Ar/N2/H2 (1∶3∶6) 350 Si (100) 薄膜生长 PE-ALD 60 [32] GaN TEG Ar/N2/H2 (1∶3∶6) 350 Si (100) 薄膜生长 PE-ALD 60 [33] GaN TEG Ar/N2/H2 (1∶3∶6) 350 c-sapphire 薄膜生长 PE-ALD 60 [34] GaN TEG N2/H2 200 Si (100) 薄膜生长 HCPA-ALD 300 [36] GaN TMG N2/H2 120—240 Si (100) 薄膜生长 HCP-ALD 50—250 [37] GaN TEG N2/H2 200 sapphire 薄膜生长 HCPA-ALD 300 [38] GaN TEG NH3/Ar 160—350 Si (100) 薄膜生长 PE-ALD 2000 [39] GaN TEG N2/H2 300 sapphire (0001) 薄膜生长 PE-ALD 50和 300 [40] GaN Ga(NMe2)3 NH3/Ar 130—250 Si (100)
4H-SiC (0002)薄膜生长 PE-ALD 2800 [41] GaN Ga(NMe2)3 NH3/Ar 130—250 Si (100), 4H-SiC (0002) 薄膜生长 PE-ALD 2800 [42] GaN TEG Ar/N2/H2 (1∶3∶6) 350 multilayer graphene 薄膜生长 PE-ALD 60 [43] GaN TEG Ar/N2/H2 (1∶3∶6) 300 graphene 薄膜生长 PE-ALD 60 [44] GaN TEG Ar/N2/H2 (1∶3∶6) ≤290 stainless steel 薄膜生长 PE-ALD 60 [45] GaN TEG Ar/N2/H2 (1∶3∶6) 200—300 Kapton 薄膜生长 PE-ALD 60 [46] GaN TEG Ar/N2/H2 (1∶3∶6) 260 MoS2 薄膜生长 PE-ALD 60 [47] GaN TEG Ar/N2/H2 (1∶3∶6) 260, 320 MoS2 薄膜生长 PE-ALD 60 [48] GaN TEG Ar/N2/H2 (1∶3∶6) 280 FTO 薄膜生长 PE-ALD 60 [49] GaN TEG Ar/N2/H2 (1∶3∶6) 280 FTO 钙钛矿太阳能电池 PE-ALD 60 [50] GaN TEG Ar/N2/H2 (1∶3∶6) 200—280 — 量子点太阳能电池 PE-ALD 60 [51] AlN AlCl3 NH3/Ar/H2 350 p-Si (100) 薄膜生长 PE-ALD 150 [52] AlN TMA Ar/N2/H2 (1∶3∶6) 350—300 Si (100) 薄膜生长 PE-ALD 60 [53] AlN TMA Ar/N2/H2 (1∶3∶6) 250 Si (100), Si (111)
sapphire薄膜生长 PE-ALD 60 [54] AlN TMA NH3 200—300 Si, sapphire 薄膜生长 PE-ALD 2500 [55] AlN TMA NH3 300 GaN 薄膜生长 PE-ALD 200 [56] AlN TMA N2/H2 200 Si (100) 薄膜生长 PE-ALD 300 [57] AlN TMA Ar/N2 300 (Homemade substrates) MEMS PE-ALD 975 [58] AlN TMA H2 plasma, NH3 325—350 SiC 薄膜生长 PE-ALD 1800 [59] TMA NH3 325—400 SiC T-ALD — AlN TMA N2/H2 300 4H-SiC 薄膜生长 PE-ALD 50—300 [60] AlN TMA NH3 (Ar) 300 Si (100), Si (111) 薄膜生长 PE-ALD 100, 200 [61] AlN TMA NH3 350 Si 薄膜生长 PE-ALD(ICP) 200
600[62] PE-ALD(CCP) 200 AlN Al(C4H9)3 N2H5Cl 200—350 — 薄膜生长 T-ALD — [63] AlN TMA N2/H2 300 Si (100) 薄膜生长, 电容器 PE-ALD 300 [64] AlN TMA Ar/N2/H2 100—250 Si (100) 薄膜生长 HCPA-ALD 25—200 [65] AlN TMA Ar/N2/H2 100—250 Si (100) 薄膜生长 HCPA-ALD 25—200 [66] AlN TMA NH3 295—342 Si, TiN 薄膜生长 T-ALD — [67] AlN TMA N2H4 175—350 p-Si 薄膜生长 T-ALD — [68] AlN TMA Monomethylhydrazine(MMH) 375—475 Si (100) 薄膜生长 T-ALD — [69] AlN 三(二甲氨基)铝 NH3 300 p-Si 薄膜生长 T-ALD — [70] AlN TMA NH3 400 GaN/AlGaN MIS-HEMT T-ALD — [71] AlN TMA NH3 360 GaN MIS-HEMT T-ALD — [72] AlN TMA N2 & NH3 300, 350 AlGaN HEMT PE-ALD 2800 [73] AlN TMA NH3 400 AlGaN HEMT T-ALD — [74] AlN TMA N2/H2 300 p-GaN LED PE-ALD — [75] AlN TMA N2 350 AlGaN Schottky diodes PE-ALD 2800 [76] AlN TMA NH3 340 GaN 异质结 T-ALD — [77] AlN TMA NH3 300 GaN 薄膜生长, 异质结 PE-ALD 200 [78] AlN TMA NH3 335 c-sapphire 异质结 T-ALD — [79] InN TMI Ar/N2 250 ± 20 sapphire 薄膜生长 PE-ALD 300 [80] InN TMI N2/H2 200 sapphire 薄膜生长 HCPA-ALD 300 [81] InN TMI NH3 240—320 Si (100) 薄膜生长 PE-ALD 2400—2800 [82] InN TMI N2, Ar/N2, Ar/N2/H2 120—240 Si (100) 薄膜生长 HCP-ALD 50—200 [83] InN TMI N2/Ar 250 GaN (0001) 薄膜生长 PE-ALD 300 [84] InN Tris (N, N-dimethyl-N', N''-diisopropylguanidinato)
indium (III), Tris (N, N'-diisopropylamidinato) indium
(III), Tris(N, N'-diisopropylformamidinato) indium (III)Ar/NH3 200—280 Si (100) 薄膜生长 PE-ALD 2800 [85] InN Tris(1,3-diisopropyltriazenide)
indium (III)NH3(Ar/NH3) 200—400 Si, 4H-SiC 薄膜生长 PE-ALD 2800 [86] InN TMI N2 190—310 Si (100), Al2O3 (0001), ZnO (0001) 薄膜生长 PE-ALD 100—200 [87] InN TMI N2(Ar) 150—300 glass, polyimide 薄膜生长 PE-ALD 200 [88] InN TMI N2 180—320 GaN (0001) 薄膜生长 PE-ALD 300 [89] InN TMI NH3/Ar 320 4H-SiC 薄膜生长 PE-ALD 2800 [90] InN TMI Ar/N2/H2(1∶3∶6) 200—300 Si (100) 薄膜生长 PE-ALD 60 [91] 表 2 使用ALD沉积III族氮化物合金薄膜的生长条件概述, 包括薄膜生长和器件应用.
Table 2. Overview of growth conditions for the deposition of group III nitride alloy films using ALD, including film growth and device applications.
材料 金属前驱体 氮前驱体 沉积温度/ ℃ 沉积衬底 应用 ALD类型 等离子体功率/W 参考文献 InGaN TMI, TEG N2/H2, N2 200 Si, quartz 薄膜生长 HCPA-ALD 300 [95] InGaN Ga(III) and In(III) triazenides NH3/Ar 350 Si (100)
4H-SiC (0001)薄膜生长 PE-ALD 2800 [96] AlGaN TMA, TMG NH3/N2/H2 200 Si (100), Si (111), c-sapphire 薄膜生长 HCPA-ALD 300 [97] AlGaN TMA, TMI, TMG N2/Ar 350—450 Si (100), a-sapphire, GaN/a-sapphire 薄膜生长 PE-ALD 300 [98] InAlN 340—300 InGaN AlGaN
InGaNTMG, TMA, TMI N2/H2 220—300 Si 薄膜生长 PE-ALD 280 [99] AlGaN TMA&TEG NH3 & N2 342 p-Si (100), TiN/SiO2/Si 薄膜生长 T-ALD — [100] AlGaN TMA, TEG NH3 335 c-GaN 异质结 ALD — [101] AlGaN TMA. TEG NH3 335 c-GaN 异质结 T-ALD — [102] AlGaN TEG NH3 335 ℃ GaN 异质结 T-ALD — [103] -
[1] Lakshmi E 1981 Thin Solid Films 83 L137
 Google Scholar
Google Scholar
[2] Porowski S 1997 Mater. Sci. Eng. B 44 407
 Google Scholar
Google Scholar
[3] Pearton S J, Ren F, Zhang A P, Lee K P 2000 Mat. Sci. Eng. R 30 55
 Google Scholar
Google Scholar
[4] Glavin N R, Chabak K D, Heller E R, Moore E A, Prusnick T A, Maruyama B, Walker Jr D E, Dorsey D L, Paduano Q, Snure M 2017 Adv. Mate. 29 1701838
 Google Scholar
Google Scholar
[5] Mizutani H, Ishikawa R, Honjo K 2017 IEEE Compound Semiconductor Integrated Circuit Symposium (CSICS) Miami, FL, USA, October 22–25, 2017 pp1–4
[6] Bentini A, Palombini D, Rampazzo D 2017 12th European Microwave Integrated Circuits Conference (EuMIC) Nuremberg, Germany, October 8–10, 2017 pp125–128
[7] Margomenos A, Kurdoghlian A, Micovic M, Shinohara K, Moyer H, Regan D C, Grabar R M, McGuire C, Wetzel M D, Chow D H 2014 IEEE Compound Semiconductor Integrated Circuit Symposium (CSICS) La Jolla, CA, USA, October 19–22, 2014 pp1–4
[8] Bui H V, Wiggers F B, Gupta A, Nguyen M D, Aarnink A A I, Jong M P D, Kovalgin A Y 2015 J. Vac. Sci. Technol. A 33 01A111
[9] Shur M 2019 Solid-State Electron. 155 65
 Google Scholar
Google Scholar
[10] Chabak K D, Walker D E, Johnson M R, Crespo A, Dabiran A M, Smith D J, Wowchak A M, Tetlak S K, Kossler M, Gillespie J K, Fitch R C, Trejo M 2011 IEEE Electr. Device Lett. 32 1677
 Google Scholar
Google Scholar
[11] Abd Rahman M N, Shuhaimi A, Abdul Khudus M I M, Anuar A, Zainorin M Z, Talik N A, Chanlek N, Abd Majid W H 2021 J. Electron. Mater. 50 2313
 Google Scholar
Google Scholar
[12] Slack G A, Tanzilli R A, Pohl R O, Vandersande J W 1987 J. Phys. Chem. Solids 48 641
 Google Scholar
Google Scholar
[13] Zhang Z P, Gao B, Fang Z, Wang X P, Tang Y Z, Sohn J, Wong H S P, Wong S S, Lo G Q 2015 IEEE Electr. Device Lett. 36 29
 Google Scholar
Google Scholar
[14] Eisele H, Schuppang J, Schnedler M, Duchamp M, Nenstiel C, Portz V, Kure T, Bügler M, Lenz A, Dähne M, Hoffmann A, Gwo S, Choi S, Speck J S, Dunin-Borkowski R E, Ebert P 2016 Phys. Rev. B 94 245201
 Google Scholar
Google Scholar
[15] Bhatta R P, Thoms B D, Alevli M, Dietz N 2007 Surf. Sci. 601 L120
 Google Scholar
Google Scholar
[16] Wang S L, Liu H X, Chen Q, Zhang H L 2016 J. Mater. Sci. Mater. El. 27 11353
 Google Scholar
Google Scholar
[17] Wu J, Walukiewicz W, Yu K M, III J W A, Haller E E, Lu H, Schaff W J, Saito Y, Nanishi Y 2002 Appl. Phys. Lett. 80 3967
 Google Scholar
Google Scholar
[18] Ciorga M, Bryja L, Misiewicz J, Paszkiewicz R, Korbutowicz R, Panek M, Paszkiewicz B, Tlaczala M 1999 Mater. Sci. Eng. B 59 16
 Google Scholar
Google Scholar
[19] Kalaitzakis F G, Konstantinidis G, Sygellou L, Kennou S, Ladas S, Pelekanos N T 2012 Microelectron. Eng. 90 115
 Google Scholar
Google Scholar
[20] Nakada Y, Aksenov I, Okumura H 1998 Appl. Phys. Lett. 73 827
 Google Scholar
Google Scholar
[21] Hemmingsson C, Paskov P P, Pozina G, Heuken M, Schineller B, Monemar B 2007 J. Cryst. Growth 300 32
 Google Scholar
Google Scholar
[22] Zhang J X, Qu Y, Chen Y Z, Uddin A, Yuan S 2005 J. Cryst. Growth 282 137
 Google Scholar
Google Scholar
[23] Etzkorn E V, Clarke D R 2004 Int. J. High Speed Electron. Syst. 14 63
 Google Scholar
Google Scholar
[24] Ozturk M K, Arslan E, Kars I, Ozcelik S, Ozbay E 2013 Mat. Sci. Semicond. Process. 16 83
 Google Scholar
Google Scholar
[25] Kizir S, Haider A, Biyikli N 2016 J. Vac. Sci. Technol. A 34 041511
 Google Scholar
Google Scholar
[26] Ozgit C, Donmez I, Alevli M, Biyikli N 2012 J. Vac. Sci. Technol. A 30 01A124
 Google Scholar
Google Scholar
[27] Maeng W J, Choi D W, Park J, Park J S 2015 J. Alloys Compd. 649 216
 Google Scholar
Google Scholar
[28] Shih H Y, Lin M C, Chen L Y, Chen M J 2014 Nanotechnology 26 014002
 Google Scholar
Google Scholar
[29] Lee S H, Kwon J D, Ahn J H, Park J S 2017 Ceram. Int. 43 6580
 Google Scholar
Google Scholar
[30] Asif Khan M, Skogman R A, Van Hove J M, Olson D T, Kuznia J N 1992 Appl. Phys. Lett. 60 1366
 Google Scholar
Google Scholar
[31] Karam N H, Parodos T, Colter P, McNulty D, Rowland W, Schetzina J, El-Masry N, Bedair S M 1995 Appl. Phys. Lett. 67 94
 Google Scholar
Google Scholar
[32] Liu S J, He Y F, Wei H Y, Qiu P, Song Y M, An Y L, Rehman A, Peng M Z, Zheng X H 2019 Chin. Phys. B 28 026801
 Google Scholar
Google Scholar
[33] Liu S J, Zhao G, He Y F, Wei H Y, Li Y F, Qu P, Song Y M, An Y L, Wang X Y, Wang X X, Cheng J D, Peng M Z, Zheng X H 2019 ACS Appl. Mater. Interfaces 11 35382
 Google Scholar
Google Scholar
[34] Liu S J, Zhao G, He Y F, Li Y F, Wei H Y, Qiu P, Wang X Y, Wang X X, Cheng J D, Peng M Z, Zaera F, Zheng X H 2020 Appl. Phys. Lett. 116 211601
 Google Scholar
Google Scholar
[35] Ozgit-Akgun C, Donmez I, Biyikli N 2013 ECS Trans. 58 289
 Google Scholar
Google Scholar
[36] Gungor N, Alevli M 2018 J. Vac. Sci. Technol. A. 36 021514
 Google Scholar
Google Scholar
[37] Shukla D, Mohammad A, Ilhom S, Willis B G, Okyay A K, Biyikli N 2021 J. Vac. Sci. Technol. A. 39 022406
 Google Scholar
Google Scholar
[38] Gungor N, Alevli M 2019 J. Vac. Sci. Technol. A. 37 050901
 Google Scholar
Google Scholar
[39] Deminskyi P, Hsu C W, Bakhit B, Rouf P, Pedersen H 2021 J. Vac. Sci. Technol. A. 39 012411
 Google Scholar
Google Scholar
[40] Lee W H, Yin Y T, Cheng P H, Shyue J J, Shiojiri M, Lin H C, Chen M J 2018 ACS Sustain. Chem. Eng. 7 487
[41] Rouf P, O’Brien N J, Buttera S C, Martinovic I, Bakhit B, Martinsson E, Palisaitis J, Hsu C W, Pedersen H 2020 J. Mater. Chem. C 8 8457
 Google Scholar
Google Scholar
[42] Rouf P, Samii R, Rönnby K, Bakhit B, Buttera S C, Martinovic I, Ojamäe L, Hsu C W, Palisaitis J, Kessler V, Pedersen H, O’Brien N J 2021 Chem. Mater. 33 3266
 Google Scholar
Google Scholar
[43] He Y F, Li M L, Liu S J, Wei H Y, Ye H Y, Song Y M, Qiu P, An Y L, Peng M Z, Zheng X H 2019 Acta Metall Sin-Engl 32 1530
 Google Scholar
Google Scholar
[44] He Y F, Song Y M, Wei H, Qiu P, Liu H, Zhu X, Tian F, Peng M Z, Zheng X H 2023 Appl. Phys. Lett. 122 041602
 Google Scholar
Google Scholar
[45] He Y F, Si Z, Shi Y A, Wei H, Peng M Z, Zheng X H 2023 Mater. Lett. 350 134801
 Google Scholar
Google Scholar
[46] He Y F, Li M, Wei H, Song Y M, Qiu P, Peng M Z, Zheng X H 2021 Appl. Surf. Sci. 566 150684
 Google Scholar
Google Scholar
[47] Song Y M, He Y F, Li Y F, Wei H Y, Qiu P, Huang Q M, He Z Q, Die J H, Peng M Z, Zheng X H 2021 Cryst. Growth Des. 21 1778
 Google Scholar
Google Scholar
[48] Song Y M, Li Y F, He Y F, Wei H Y, Qiu P, Hu X T, Su Z L, Jiang Y, Peng M Z, Zheng X H 2022 ACS Appl. Mater. Interfaces 14 16866
 Google Scholar
Google Scholar
[49] Qiu P, Wei H Y, An Y L, Wu Q, Du W, Jiang Z, Zhou L, Gao C, Liu S J, He Y F, Song Y M, Peng M Z, Zheng X H 2020 Ceram. Int. 46 5765
 Google Scholar
Google Scholar
[50] Wei H Y, Wu J, Qiu P, Liu S J, He Y F, Peng M Z, Li D, Meng Q, Zaera F, Zheng X H 2019 J. Mater. Chem. A 7 25347
 Google Scholar
Google Scholar
[51] Qiu P, Wei H Y, Huang Q, Yu M, Hu Y, Zhu X, Liu H, Zheng X H 2023 Ceram. Int. 49 22030
 Google Scholar
Google Scholar
[52] Lee Y J, Kang S W 2004 Thin Solid Films 446 227
 Google Scholar
Google Scholar
[53] Liu S J, Peng M Z, Hou C, He Y F, Li M, Zheng X H 2017 Nanoscale Res. Lett. 12 279
 Google Scholar
Google Scholar
[54] Liu S J, Li Y F, Tao J, Tang R, Zheng X H 2023 Crystals 13 910
[55] Zhang X Y, Peng D C, Han J, Ren F B, Jiang S C, Tseng M C, Ruan Y J, Zuo J, Wu W Y, Wuu D S, Huang C J, Lien S Y, Zhu W Z 2023 Surf. Interface 36 102589
 Google Scholar
Google Scholar
[56] Schilirò E, Giannazzo F, Bongiorno C, Di Franco S, Greco G, Roccaforte F, Prystawko P, Kruszewski P, Leszczyński M, Krysko M, Michon A, Cordier Y, Cora I, Pecz B, Gargouri H, Nigro R L 2019 Mat. Sci. Semicond. Process. 97 35
 Google Scholar
Google Scholar
[57] Gungor N, Alevli M 2022 J. Vac. Sci. Technol. A 40 022404
 Google Scholar
Google Scholar
[58] Strnad N A, Sarney W L, Rayner G B, Benoit R R, Fox G R, Rudy R Q, Larrabee T J, Shallenberger J, Pulskamp J S 2022 J. Vac. Sci. Technol. A 40 042403
 Google Scholar
Google Scholar
[59] Tian L, Ponton S, Benz M, Crisci A, Reboud R, Giusti G, Volpi F, Rapenne L, Vallée C, Pons M, Mantoux A, Jiménez C, Blanquet E 2018 Surf. Coat. Technol. 347 181
 Google Scholar
Google Scholar
[60] Kao W C, Lee W H, Yi S H, Shen T H, Lin H C, Chen M J 2019 RSC Adv. 9 12226
 Google Scholar
Google Scholar
[61] Seppanen H, Kim I, Etula J, Ubyivovk E, Bouravleuv A, Lipsanen H 2019 Materials 12 610
[62] Kot M, Henkel K, Naumann F, Gargouri H, Lupina L, Wilker V, Kus P, Poz´arowska E, Garain S, Rouissi Z, Schmeißer D 2019 J. Vac. Sci. Technol. A 37 020913
[63] Dallaev R, Sobola D, Tofel P, Škvarenina Ľ, Sedlák P 2020 Coatings 10 954
[64] Legallais M, Mehdi H, David S, Bassani F, Labau S, Pelissier B, Baron T, Martinez E, Ghibaudo G, Salem B 2020 ACS Appl. Mater. Interfaces 12 39870
 Google Scholar
Google Scholar
[65] Mohammad A, Shukla D, Ilhom S, Willis B, Johs B, Okyay A K, Biyikli N 2019 J. Vac. Sci. Technol. A 37 020927
 Google Scholar
Google Scholar
[66] Ilhom S, Shukla D, Mohammad A, Grasso J, Willis B, Biyikli N 2020 J. Vac. Sci. Technol. A 38 022405
 Google Scholar
Google Scholar
[67] Yun H J, Kim H, Choi B J 2020 Ceram. Int. 46 13372
 Google Scholar
Google Scholar
[68] Jung Y C, Hwang S M, Le D N, Kondusamy A L N, Mohan J, Kim S W, Kim J H, Lucero A T, Ravichandran A, Kim H S, Kim S J, Choi R, Ahn J, Alvarez D, Spiegelman J, Kim J 2020 Materials 13 3387
 Google Scholar
Google Scholar
[69] Parkhomenko R G, De Luca O, Kolodziejczyk L, Modin E, Rudolf P, Martinez Martinez D, Cunha L, Knez M 2021 Dalton Trans. 50 15062
 Google Scholar
Google Scholar
[70] Tiwari C, Dixit A 2021 Appl. Phys. A 127 862
[71] Liu X Y, Zhao S X, Zhang L Q, Huang H F, Shi J S, Zhang C M, Lu H L, Wang P F, Zhang D W 2015 Nanoscale Res. Lett. 10 109
 Google Scholar
Google Scholar
[72] Zhang L Q, Wang P F 2018 Jpn. J. Appl. Phys. 57 096502
 Google Scholar
Google Scholar
[73] Tzou A J, Chu K H, Lin I F, Ostreng E, Fang Y S, Wu X P, Wu B W, Shen C H, Shieh J M, Yeh W K, Chang C Y, Kuo H C 2017 Nanoscale Res. Lett. 12 315
 Google Scholar
Google Scholar
[74] Zhao S X, Liu X Y, Zhang L Q, Huang H F, Shi J S, Wang P F 2016 Nanoscale Res. Lett. 11 137
 Google Scholar
Google Scholar
[75] Kim K, Hua M, Liu D, Kim J, Chen K J, Ma Z 2018 Nano Energy 43 259
 Google Scholar
Google Scholar
[76] Chen S W H, Yang D R, You N J, Ho W C, Tzou J, Kuo H C, Shieh J M 2021 IEEE Trans. Nanotechnol. 20 489
 Google Scholar
Google Scholar
[77] Kim H, Kwon Y, Choi B J 2019 Thin Solid Films 670 41
 Google Scholar
Google Scholar
[78] Schiliro E, Giannazzo F, Di Franco S, Greco G, Fiorenza P, Roccaforte F, Prystawko P, Kruszewski P, Leszczynski M, Cora I, Pecz B, Fogarassy Z, Lo Nigro R 2021 Nanomaterials 11 3316
 Google Scholar
Google Scholar
[79] Kim H, Yun H J, Choi S, Choi B J 2020 Appl. Phys. A 126 449
 Google Scholar
Google Scholar
[80] Boris D R, Anderson V R, Nepal N, Johnson S D, Robinson Z R, Kozen A C, Eddy Jr. C R, Walton S G 2018 J. Vac. Sci. Technol. A 36 051503
 Google Scholar
Google Scholar
[81] Alevli M, Gungor N 2020 J. Vac. Sci. Technol. A 38 062407
 Google Scholar
Google Scholar
[82] Deminskyi P, Rouf P, Ivanov I G, Pedersen H 2019 J. Vac. Sci. Technol. A 37 020926
 Google Scholar
Google Scholar
[83] Ilhom S, Mohammad A, Shukla D, Grasso J, Willis B G, Okyay A K, Biyikli N 2020 RSC Adv. 10 27357
 Google Scholar
Google Scholar
[84] Woodward J M, Rosenberg S G, Boris D R, Johnson M J, Walton S G, Johnson S D, Robinson Z R, Nepal N, Ludwig K F, Hite J K, Eddy C R 2022 J. Vac. Sci. Technol. A 40 062405
 Google Scholar
Google Scholar
[85] Rouf P, O’Brien N J, Rönnby K, Samii R, Ivanov I G, Ojamäe L, Pedersen H 2019 J. Phys. Chem. C 123 25691
 Google Scholar
Google Scholar
[86] O’Brien N J, Rouf P, Samii R, Rönnby K, Buttera S C, Hsu C-W, Ivanov I G, Kessler V, Ojamäe L, Pedersen H 2020 Chem. Mater. 32 4481
 Google Scholar
Google Scholar
[87] Feng X C, Peng H, Gong J H, Wang W, Liu H, Quan Z J, Pan S, Wang L 2018 J. Appl. Phys. 124 243104
 Google Scholar
Google Scholar
[88] Peng H, Feng X C, Gong J H, Wang W, Liu H, Quan Z J, Pan S, Wang L 2018 Appl. Surf. Sci. 459 830
 Google Scholar
Google Scholar
[89] Woodward J M, Rosenberg S G, Kozen A C, Nepal N, Johnson S D, Wagenbach C, Rowley A H, Robinson Z R, Joress H, Ludwig K F, Eddy C R 2019 J. Vac. Sci. Technol. A 37 030901
 Google Scholar
Google Scholar
[90] Hsu C W, Deminskyi P, Martinovic I, Ivanov I G, Palisaitis J, Pedersen H 2020 Appl. Phys. Lett. 117 093101
 Google Scholar
Google Scholar
[91] An Y L, He Y F, Wei H Y, Liu S J, Li M, Song Y M, Qiu P, Rehman A, Zheng X H, Peng M Z 2019 Results Phys. 12 804
 Google Scholar
Google Scholar
[92] Ho I H, Stringfellow G B 1996 MRS Online Proc. Libr. 449 871
 Google Scholar
Google Scholar
[93] Surender S, Prabakaran K, Loganathan R, Pradeep S, Singh S, Baskar K 2017 J. Cryst. Growth 468 249
 Google Scholar
Google Scholar
[94] Huang Y 2012 J. Photon. Energy 2 028501
 Google Scholar
Google Scholar
[95] Haider A, Kizir S, Ozgit-Akgun C, Goldenberg E, Leghari S A, Okyay A K, Biyikli N 2015 J. Mater. Chem. C 3 9620
 Google Scholar
Google Scholar
[96] Rouf P, Palisaitis J, Bakhit B, O'Brien N J, Pedersen H 2021 J. Mater. Chem. C 9 13077
 Google Scholar
Google Scholar
[97] Ozgit-Akgun C, Goldenberg E, Okyay A K, Biyikli N 2014 J. Mater. Chem. C 2 2123
 Google Scholar
Google Scholar
[98] Nepal N, Anderson V R, Hite J K, Eddy C R 2015 Thin Solid Films 589 47
 Google Scholar
Google Scholar
[99] Portillo M C, Gallardo Hernández S, Panecatl Bernal Y, Martinez Velis I, Villanueva Cab J, Alcántara S, Alvarado J 2020 Opt. Mater. 108 110206
 Google Scholar
Google Scholar
[100] Choi S, Ansari A S, Yun H J, Kim H, Shong B, Choi B J 2021 J. Alloy. Compd. 854 157186
 Google Scholar
Google Scholar
[101] Kim H, Choi S, Choi B J 2020 Coatings 10 194
 Google Scholar
Google Scholar
[102] Kim H, Choi S, Choi B J 2020 Coatings 10 489
 Google Scholar
Google Scholar
[103] Kim H, Yun H J, Choi S, Choi B J 2020 Mater. Trans. 61 88
 Google Scholar
Google Scholar
Catalog
Metrics
- Abstract views: 1937
- PDF Downloads: 85
- Cited By: 0














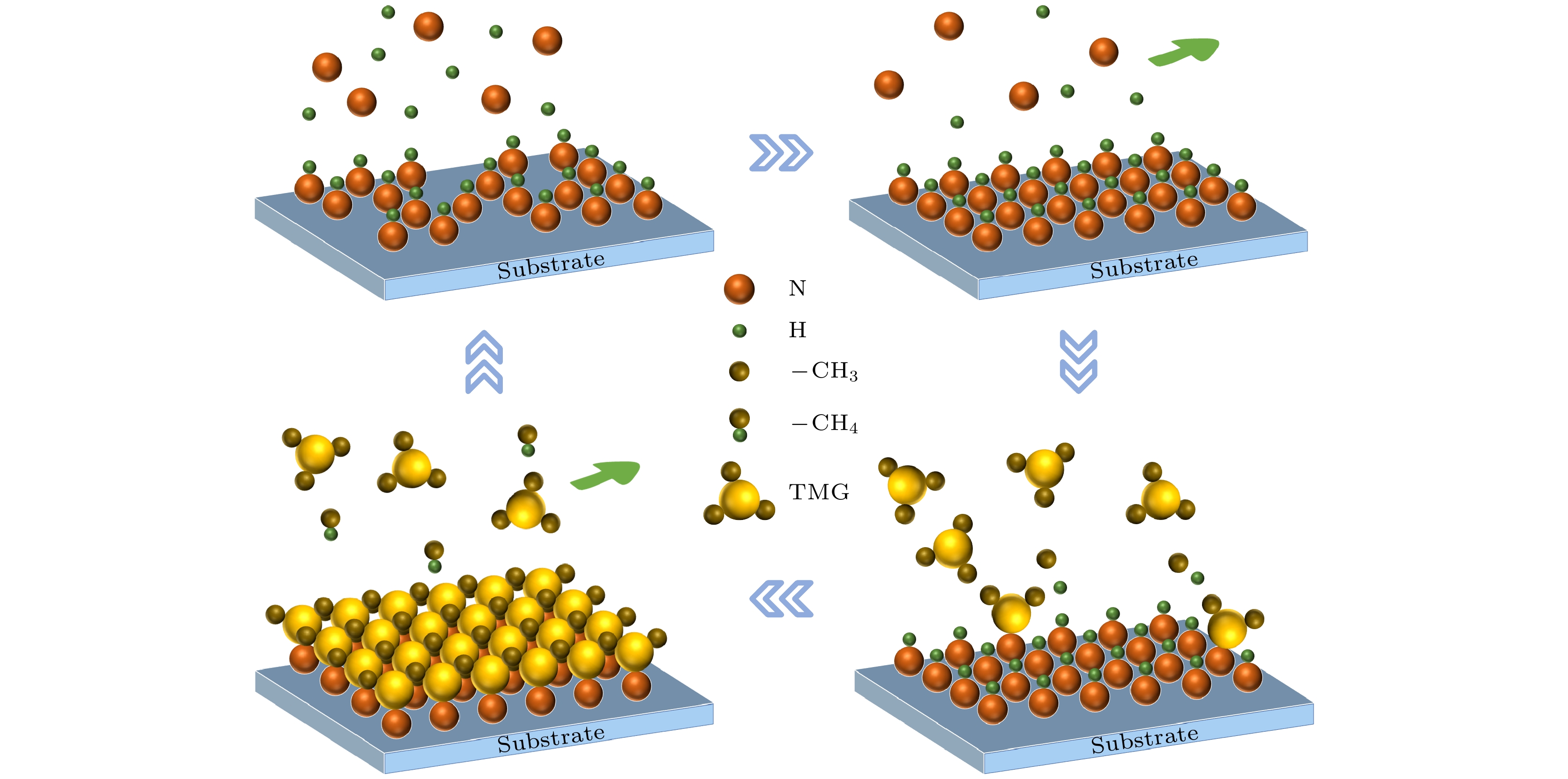
 DownLoad:
DownLoad: