-
Diamond has a wide band gap, high carrier mobility, and high thermal conductivity, thereby possessing great potential applications in high power, and high temperature electronics devices, and also inhigh temperature logic circuit. In this work, we fabricate a hydrogen terminated diamond metal-oxide-semiconductor field effect transistor (MOSFET) by using the atomic layer deposition grown Al2O3 as a gate dielectric and passivation layer. The device has a gate length and width of 4 μm and 50 μm, respectively. The device delivers a maximum output current of about 113.4 mA/mm at VGS of –6 V and an ultra-high on/off ratio of 109. In addition, we fabricate three resistors, respectively, with an interelectrode distance of 20, 80 and 160 μm, corresponding to the resistance value of 16.7, 69.5 and 136.4 kΩ, respectively. The logic inverter is realized by combining the MOSFET with the load resistance, and the characteristics of the logic inverter are demonstrated successfully, which indicates that the diamond MOSFET has great potential applications in future logic circuits.
-
Keywords:
- diamond /
- filed effect transistor /
- logic inverter
[1] Wort C J H, Balmer R S 2008 Mater. Today 11 22
 Google Scholar
Google Scholar
[2] Baliga B J 1989 IEEE Electr. Device Lett. 10 455
 Google Scholar
Google Scholar
[3] Achard J, Silva F, Tallaire A, Bonnin X, Lombardi G, Hassouni K, Gicquel A 2007 J. Phys. D:Appl. Phys. 40 6175
 Google Scholar
Google Scholar
[4] Kasu M, Ueda K, Ye H, Yamauchi Y, Sasaki S, Makimoto T 2006 Diam. Relat. Mater. 15 783
 Google Scholar
Google Scholar
[5] Hirama K, Sato H, Harada Y, Yamamoto H, Kasu M 2012 IEEE Electr. Device Lett. 33 1111
 Google Scholar
Google Scholar
[6] Kawarada H, Tsuboi H, Naruo T, Yamada T, Xu D, Daicho A, Saito T, Hiraiwa A 2014 Appl. Phys. Lett. 105 4
 Google Scholar
Google Scholar
[7] Liu J, Yu H, Shao S, Tu J, Zhu X, Yuan X, Wei J, Chen L, Ye H, Li C 2020 Diam. Relat. Mater. 104 107750
 Google Scholar
Google Scholar
[8] Yu X X, Zhou J J, Qi C J, Cao Z Y, Kong Y C, Chen T S 2018 IEEE Electr. Device Lett. 39 1373
 Google Scholar
Google Scholar
[9] Ueda K, Kasu M, Yamauchi Y, Makimoto T, Schwitters M, Twitchen D J, Scarsbrook G A, Coe S E 2006 IEEE Electr. Device Lett. 27 570
 Google Scholar
Google Scholar
[10] Kitabayashi Y, Kudo T, Tsuboi H, Yamada T, Xu D, Shibata M, Matsumura D, Hayashi Y, Syamsul M, Inaba M, Hiraiwa A, Kawarada H 2017 IEEE Electr. Device Lett. 38 363
 Google Scholar
Google Scholar
[11] Imanishi S, Horikawa K, Oi N, Okubo S, Kageura T, Hiraiwa A, Kawarada H 2019 IEEE Electr. Device Lett. 40 279
 Google Scholar
Google Scholar
[12] Russell S A O, Sharabi S, Tallaire A, Moran D A J 2012 IEEE Electr. Device Lett. 33 1471
 Google Scholar
Google Scholar
[13] Kasu M, Ueda K, Ye H, Yamauchi Y, Sasaki S, Makimoto T 2005 IEEE Electr. Device Lett. 41 1249
 Google Scholar
Google Scholar
[14] Ren Z Y, Yuan G S, Zhang J F, Xu L, Zhang J C, Chen W J, Hao Y 2018 Aip. Adv. 8 6
 Google Scholar
Google Scholar
[15] Daicho A, Saito T, Kurihara S, Hiraiwa A, Kawarada H 2014 J. Appl. Phys. 115 4
 Google Scholar
Google Scholar
[16] Wang Y F, Chang X, Zhang X, Fu J, Fan S, Bu R, Zhang J, Wang W, Wang H X, Wang J 2018 Diam. Relat. Mater. 81 113
 Google Scholar
Google Scholar
[17] Ren Z, Lv D, Xu J, Zhang J, Zhang J, Su K, Zhang C, Hao Y 2020 Appl. Phys. Lett. 116 013503
 Google Scholar
Google Scholar
[18] Liu J W, Liao M Y, Imura M, Watanabe E, Oosato H, Koide Y 2014 Appl. Phys. Lett. 105 082110
 Google Scholar
Google Scholar
[19] Liu J W, Oosato H, Liao M Y, Imura M, Watanabe E, Koide Y 2018 Appl. Phys. Lett. 112 153501
 Google Scholar
Google Scholar
[20] Liu J, Ohsato H, Liao M, Imura M, Watanabe E, Koide Y 2017 IEEE Electr. Device. Lett. 38 922
 Google Scholar
Google Scholar
[21] Wang J J, He Z Z, Yu C, Song X B, Xu P, Zhang P W, Guo H, Liu J L, Li C M, Cai S J, Feng Z H 2014 Diam. Relat. Mater. 43 43
 Google Scholar
Google Scholar
[22] Ren Z, Zhang J, Zhang J, Zhang C, Xu S, Li Y, Hao Y 2017 IEEE Electr. Device Lett. 38 786
 Google Scholar
Google Scholar
[23] Yamaguchi T, Umezawa H, Ohmagari S, Koizumi H, Kaneko J H 2021 Appl. Phys. Lett. 118 162105
 Google Scholar
Google Scholar
[24] Inaba M, Muta T, Kobayashi M, Saito T, Shibata M, Matsumura D, Kudo T, Hiraiwa A, Kawarada H 2016 Appl. Phys. Lett. 109 033503
 Google Scholar
Google Scholar
[25] Kawarada H, Yamada T, Xu D, Kitabayashi Y, Shibata M, Matsumura D, Kobayashi M, Saito T, Kudo T, Inaba M, Hiraiwa A, Ieee. 2016 Diamond MOSFETs using 2D Hole Gas with 1700 V Breakdown Voltage. (New York: Ieee) p483
[26] Syamsul M, Kitabayashi Y, Kudo T, Matsumura D, Kawarada H 2017 IEEE Electr. Device. Lett. 38 607
 Google Scholar
Google Scholar
-
表 1 不同条件沉积的Al2O3介质的氢终端金刚石MOSFET器件的最大输出电流密度
Table 1. Summarization of the characterization of the H-diamond MOSFETs with the different temperatures grown Al2O3 as gate dielectrics.
-
[1] Wort C J H, Balmer R S 2008 Mater. Today 11 22
 Google Scholar
Google Scholar
[2] Baliga B J 1989 IEEE Electr. Device Lett. 10 455
 Google Scholar
Google Scholar
[3] Achard J, Silva F, Tallaire A, Bonnin X, Lombardi G, Hassouni K, Gicquel A 2007 J. Phys. D:Appl. Phys. 40 6175
 Google Scholar
Google Scholar
[4] Kasu M, Ueda K, Ye H, Yamauchi Y, Sasaki S, Makimoto T 2006 Diam. Relat. Mater. 15 783
 Google Scholar
Google Scholar
[5] Hirama K, Sato H, Harada Y, Yamamoto H, Kasu M 2012 IEEE Electr. Device Lett. 33 1111
 Google Scholar
Google Scholar
[6] Kawarada H, Tsuboi H, Naruo T, Yamada T, Xu D, Daicho A, Saito T, Hiraiwa A 2014 Appl. Phys. Lett. 105 4
 Google Scholar
Google Scholar
[7] Liu J, Yu H, Shao S, Tu J, Zhu X, Yuan X, Wei J, Chen L, Ye H, Li C 2020 Diam. Relat. Mater. 104 107750
 Google Scholar
Google Scholar
[8] Yu X X, Zhou J J, Qi C J, Cao Z Y, Kong Y C, Chen T S 2018 IEEE Electr. Device Lett. 39 1373
 Google Scholar
Google Scholar
[9] Ueda K, Kasu M, Yamauchi Y, Makimoto T, Schwitters M, Twitchen D J, Scarsbrook G A, Coe S E 2006 IEEE Electr. Device Lett. 27 570
 Google Scholar
Google Scholar
[10] Kitabayashi Y, Kudo T, Tsuboi H, Yamada T, Xu D, Shibata M, Matsumura D, Hayashi Y, Syamsul M, Inaba M, Hiraiwa A, Kawarada H 2017 IEEE Electr. Device Lett. 38 363
 Google Scholar
Google Scholar
[11] Imanishi S, Horikawa K, Oi N, Okubo S, Kageura T, Hiraiwa A, Kawarada H 2019 IEEE Electr. Device Lett. 40 279
 Google Scholar
Google Scholar
[12] Russell S A O, Sharabi S, Tallaire A, Moran D A J 2012 IEEE Electr. Device Lett. 33 1471
 Google Scholar
Google Scholar
[13] Kasu M, Ueda K, Ye H, Yamauchi Y, Sasaki S, Makimoto T 2005 IEEE Electr. Device Lett. 41 1249
 Google Scholar
Google Scholar
[14] Ren Z Y, Yuan G S, Zhang J F, Xu L, Zhang J C, Chen W J, Hao Y 2018 Aip. Adv. 8 6
 Google Scholar
Google Scholar
[15] Daicho A, Saito T, Kurihara S, Hiraiwa A, Kawarada H 2014 J. Appl. Phys. 115 4
 Google Scholar
Google Scholar
[16] Wang Y F, Chang X, Zhang X, Fu J, Fan S, Bu R, Zhang J, Wang W, Wang H X, Wang J 2018 Diam. Relat. Mater. 81 113
 Google Scholar
Google Scholar
[17] Ren Z, Lv D, Xu J, Zhang J, Zhang J, Su K, Zhang C, Hao Y 2020 Appl. Phys. Lett. 116 013503
 Google Scholar
Google Scholar
[18] Liu J W, Liao M Y, Imura M, Watanabe E, Oosato H, Koide Y 2014 Appl. Phys. Lett. 105 082110
 Google Scholar
Google Scholar
[19] Liu J W, Oosato H, Liao M Y, Imura M, Watanabe E, Koide Y 2018 Appl. Phys. Lett. 112 153501
 Google Scholar
Google Scholar
[20] Liu J, Ohsato H, Liao M, Imura M, Watanabe E, Koide Y 2017 IEEE Electr. Device. Lett. 38 922
 Google Scholar
Google Scholar
[21] Wang J J, He Z Z, Yu C, Song X B, Xu P, Zhang P W, Guo H, Liu J L, Li C M, Cai S J, Feng Z H 2014 Diam. Relat. Mater. 43 43
 Google Scholar
Google Scholar
[22] Ren Z, Zhang J, Zhang J, Zhang C, Xu S, Li Y, Hao Y 2017 IEEE Electr. Device Lett. 38 786
 Google Scholar
Google Scholar
[23] Yamaguchi T, Umezawa H, Ohmagari S, Koizumi H, Kaneko J H 2021 Appl. Phys. Lett. 118 162105
 Google Scholar
Google Scholar
[24] Inaba M, Muta T, Kobayashi M, Saito T, Shibata M, Matsumura D, Kudo T, Hiraiwa A, Kawarada H 2016 Appl. Phys. Lett. 109 033503
 Google Scholar
Google Scholar
[25] Kawarada H, Yamada T, Xu D, Kitabayashi Y, Shibata M, Matsumura D, Kobayashi M, Saito T, Kudo T, Inaba M, Hiraiwa A, Ieee. 2016 Diamond MOSFETs using 2D Hole Gas with 1700 V Breakdown Voltage. (New York: Ieee) p483
[26] Syamsul M, Kitabayashi Y, Kudo T, Matsumura D, Kawarada H 2017 IEEE Electr. Device. Lett. 38 607
 Google Scholar
Google Scholar
Catalog
Metrics
- Abstract views: 8306
- PDF Downloads: 158
- Cited By: 0














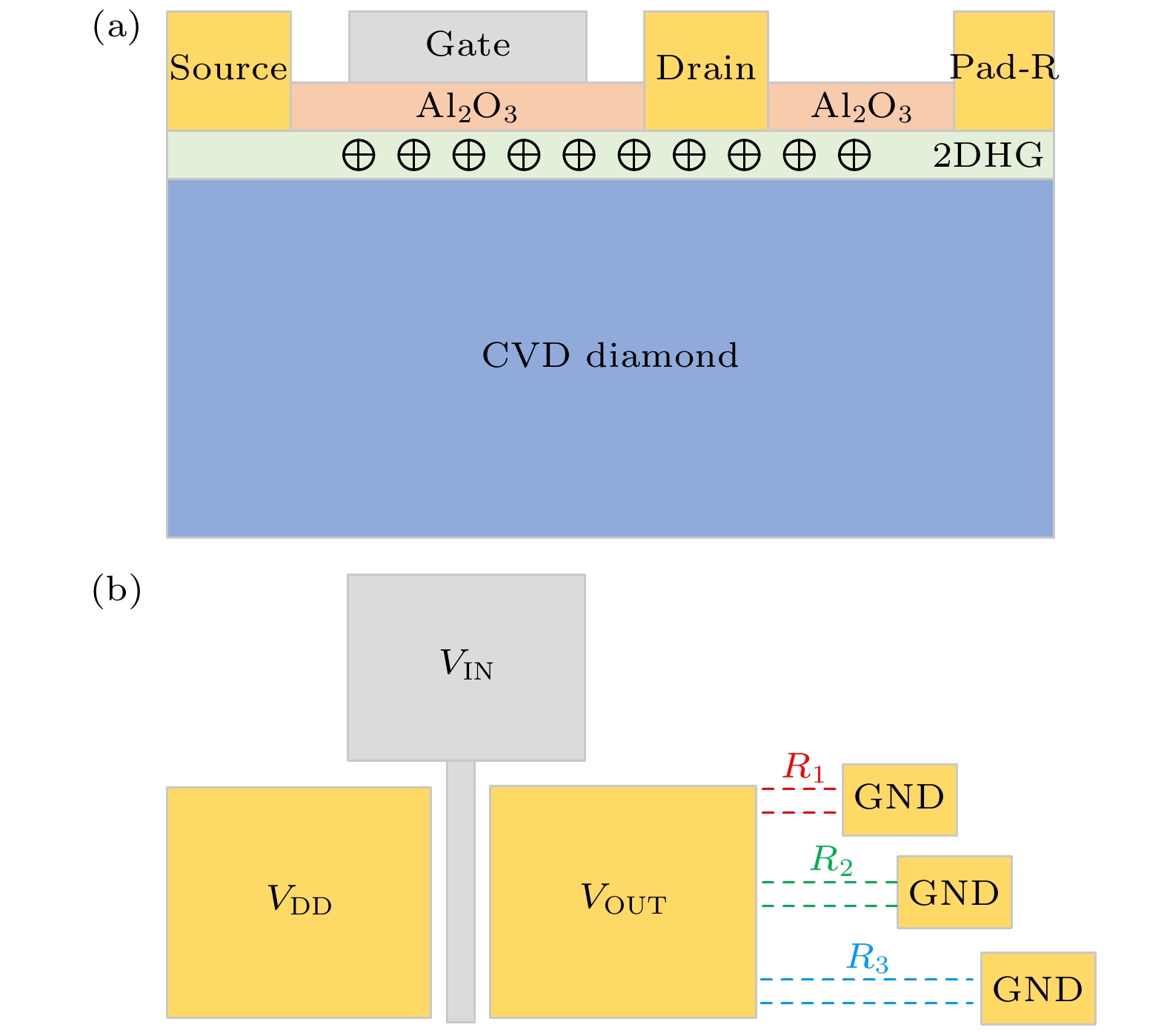
 DownLoad:
DownLoad: