-
Semiconductor temperature sensors have been widely used in medical, industrial, aviation and civil fields due to their advantages such as high sensitivity, small size, low power consumption and strong anti-interference ability. However, most Si-based temperature sensors are not suitable for the application in high-temperature environments. The new AlGaN/GaN heterojunction material not only has a wide band gap, but also has a high two-dimensional electron gas concentration and carrier mobility. Therefore, the device made with it not only has good electrical properties, but also can be applied in ultra-high environments. In this paper, a temperature sensor based on gateless AlGaN/GaN high electron mobility transistor structure was fabricated and its temperature-dependent electrical properties were characterized. The temperature dependence of current-voltage characteristics of the device were tested from 50 to 400 °C. The sensitivity of the device was studied as a function of the channel aspect ratio of the device. The stability of electrical properties was characterized after heating in air and nitrogen at 300—500 °C for 1 hour. The theoretical and experimental results show that as the aspect ratio of the device increases, the sensitivity of the device increases. At a fixed current of 0.01 A, the average sensitivity of the device voltage with temperature changes is 44.5 mV/°C. Meanwhile, the good high temperature retention stability is shown during stability experiments.
-
Keywords:
- GaN /
- high electron mobility transistor /
- temperature sensor /
- sensitivity
[1] 张洵, 靳东明, 刘理天 2006 传感器与微系统 3 1
 Google Scholar
Google Scholar
Zhang X, Jin D M, Liu L T 2006 Transd. Microsys. Technol. 3 1
 Google Scholar
Google Scholar
[2] Rue B, Flandre D 2007 Proccedings 2007 IEEE International SOI Conference Indian Wells, CA, USA, Oct. 1−4, 2007 p111
[3] de Souza M, Rue B, Flandre D, Pavanello M A 2009 Proccedings 2009 IEEE International SOI Conference Foster City, CA, USA, Oct 5−8, 2009 p1
[4] Xie G, Edward X, Niloufar H, Zhang B, Fred Y F, Wai T N 2012 Chin. Phys. B 21 086105
 Google Scholar
Google Scholar
[5] 段宝兴, 杨银堂 2014 物理学报 63 057302
 Google Scholar
Google Scholar
Duan B X, Yang Y T 2014 Acta Phys. Sin. 63 057302
 Google Scholar
Google Scholar
[6] Ambacher O, Smart J, Shealy J R, Weimann N G, Chu K, Murphy M, Schaff W J, Eastman L F, Dimitrov R, Wittmer L, Stutzmann M, Rieger W, Hilsenbeck J 1999 J. Appl. Phys. 85 3222
 Google Scholar
Google Scholar
[7] 孔月婵, 郑有炓, 周春红, 邓永桢, 顾书林, 沈波, 张荣, 韩平, 江若琏, 施毅 2004 物理学报 53 2320
 Google Scholar
Google Scholar
Kong Y C, Zheng Y D, Zhou C H, Deng Y Z, Gu S L, Shen B, Zhang R, Han P, Jiang R L, Shi Y 2004 Acta Phys. Sin. 53 2320
 Google Scholar
Google Scholar
[8] Kwan A M H, Guan Y, Liu X S, Chen K J 2014 IEEE Trans. Electron Devices 61 2970
 Google Scholar
Google Scholar
[9] Rao S, Pangallo G, Della Corte F G 2016 IEEE Trans. Electron Devices 63 414
 Google Scholar
Google Scholar
[10] Matthus C D, Erlbacher T, Hess A, Bauer A J, Frey L 2017 IEEE Trans Electron Devices 64 3399
 Google Scholar
Google Scholar
[11] Madhusoodhanan S, Sandoval S, Zhao Y, Ware M E, Chen Z 2017 IEEE Electr Device Lett. 38 1105
 Google Scholar
Google Scholar
[12] Pristavu G, Brezeanu G, Pascu R, Draghici F, Badila M 2019 Mater. Sci. Semicond. Process. 94 64
 Google Scholar
Google Scholar
[13] 顾江, 王强, 鲁宏 2011 物理学报 60 077107
 Google Scholar
Google Scholar
Gu J, Wang Q, Lu H 2011 Acta Phys. Sin. 60 077107
 Google Scholar
Google Scholar
[14] 刘艳 2017 博士学位论文 (济南: 山东大学)
Liu Y 2017 Ph. D. Dissertation (Jinan: Shandong University) (in Chinese)
[15] Huque M A, Eliza S A, Rahman T, Huq H F, Islam S K 2009 Solid State Electron. 53 341
 Google Scholar
Google Scholar
[16] Yahyazadeh R, Hashempour Z 2010 27 th International Conference on Microelectronics (MIEL 2010) Nis, Serbia, May 16−19, 2010 p189
[17] Iwanaga H, Kunishige A, Takeuchi S 2000 J. Mater. Sci. 35 2451
 Google Scholar
Google Scholar
[18] Akita M, Kishimoto S, Mizutani T 2001 IEEE Electron Device Lett. 22 376
 Google Scholar
Google Scholar
[19] Chang Y C, Tong K Y, Surya C 2005 Semicond. Sci. Technol. 20 188
 Google Scholar
Google Scholar
[20] Nagelkerke N J D 1991 Biometrika 78 691
 Google Scholar
Google Scholar
[21] 任舰 2017 博士学位论文 (无锡: 江南大学)
Ren J 2017 Ph. D. Dissertation (Wuxi: Jiangnan University) (in Chinese)
[22] 陈伟伟 2016 博士学位论文 (西安: 西安电子科技大学)
Chen W W 2016 Ph. D. Dissertation (Xi’an: Xidian University) (in Chinese)
-
表 1 一些不同结构的半导体高温温度传感器
Table 1. Some semiconductor high temperature sensors in various structures.
表 2 拟合参数列表
Table 2. List of fitting parameters.
参数 μ300 K φB(m) Nd dAlGaN εAlGaN(m) 单位 cm2/(V·s) eV cm–3 nm ε0 值 1100 0.85+1.3 m 3 × 1017 20 10.4–0.3 m -
[1] 张洵, 靳东明, 刘理天 2006 传感器与微系统 3 1
 Google Scholar
Google Scholar
Zhang X, Jin D M, Liu L T 2006 Transd. Microsys. Technol. 3 1
 Google Scholar
Google Scholar
[2] Rue B, Flandre D 2007 Proccedings 2007 IEEE International SOI Conference Indian Wells, CA, USA, Oct. 1−4, 2007 p111
[3] de Souza M, Rue B, Flandre D, Pavanello M A 2009 Proccedings 2009 IEEE International SOI Conference Foster City, CA, USA, Oct 5−8, 2009 p1
[4] Xie G, Edward X, Niloufar H, Zhang B, Fred Y F, Wai T N 2012 Chin. Phys. B 21 086105
 Google Scholar
Google Scholar
[5] 段宝兴, 杨银堂 2014 物理学报 63 057302
 Google Scholar
Google Scholar
Duan B X, Yang Y T 2014 Acta Phys. Sin. 63 057302
 Google Scholar
Google Scholar
[6] Ambacher O, Smart J, Shealy J R, Weimann N G, Chu K, Murphy M, Schaff W J, Eastman L F, Dimitrov R, Wittmer L, Stutzmann M, Rieger W, Hilsenbeck J 1999 J. Appl. Phys. 85 3222
 Google Scholar
Google Scholar
[7] 孔月婵, 郑有炓, 周春红, 邓永桢, 顾书林, 沈波, 张荣, 韩平, 江若琏, 施毅 2004 物理学报 53 2320
 Google Scholar
Google Scholar
Kong Y C, Zheng Y D, Zhou C H, Deng Y Z, Gu S L, Shen B, Zhang R, Han P, Jiang R L, Shi Y 2004 Acta Phys. Sin. 53 2320
 Google Scholar
Google Scholar
[8] Kwan A M H, Guan Y, Liu X S, Chen K J 2014 IEEE Trans. Electron Devices 61 2970
 Google Scholar
Google Scholar
[9] Rao S, Pangallo G, Della Corte F G 2016 IEEE Trans. Electron Devices 63 414
 Google Scholar
Google Scholar
[10] Matthus C D, Erlbacher T, Hess A, Bauer A J, Frey L 2017 IEEE Trans Electron Devices 64 3399
 Google Scholar
Google Scholar
[11] Madhusoodhanan S, Sandoval S, Zhao Y, Ware M E, Chen Z 2017 IEEE Electr Device Lett. 38 1105
 Google Scholar
Google Scholar
[12] Pristavu G, Brezeanu G, Pascu R, Draghici F, Badila M 2019 Mater. Sci. Semicond. Process. 94 64
 Google Scholar
Google Scholar
[13] 顾江, 王强, 鲁宏 2011 物理学报 60 077107
 Google Scholar
Google Scholar
Gu J, Wang Q, Lu H 2011 Acta Phys. Sin. 60 077107
 Google Scholar
Google Scholar
[14] 刘艳 2017 博士学位论文 (济南: 山东大学)
Liu Y 2017 Ph. D. Dissertation (Jinan: Shandong University) (in Chinese)
[15] Huque M A, Eliza S A, Rahman T, Huq H F, Islam S K 2009 Solid State Electron. 53 341
 Google Scholar
Google Scholar
[16] Yahyazadeh R, Hashempour Z 2010 27 th International Conference on Microelectronics (MIEL 2010) Nis, Serbia, May 16−19, 2010 p189
[17] Iwanaga H, Kunishige A, Takeuchi S 2000 J. Mater. Sci. 35 2451
 Google Scholar
Google Scholar
[18] Akita M, Kishimoto S, Mizutani T 2001 IEEE Electron Device Lett. 22 376
 Google Scholar
Google Scholar
[19] Chang Y C, Tong K Y, Surya C 2005 Semicond. Sci. Technol. 20 188
 Google Scholar
Google Scholar
[20] Nagelkerke N J D 1991 Biometrika 78 691
 Google Scholar
Google Scholar
[21] 任舰 2017 博士学位论文 (无锡: 江南大学)
Ren J 2017 Ph. D. Dissertation (Wuxi: Jiangnan University) (in Chinese)
[22] 陈伟伟 2016 博士学位论文 (西安: 西安电子科技大学)
Chen W W 2016 Ph. D. Dissertation (Xi’an: Xidian University) (in Chinese)
计量
- 文章访问数: 15757
- PDF下载量: 166
- 被引次数: 0













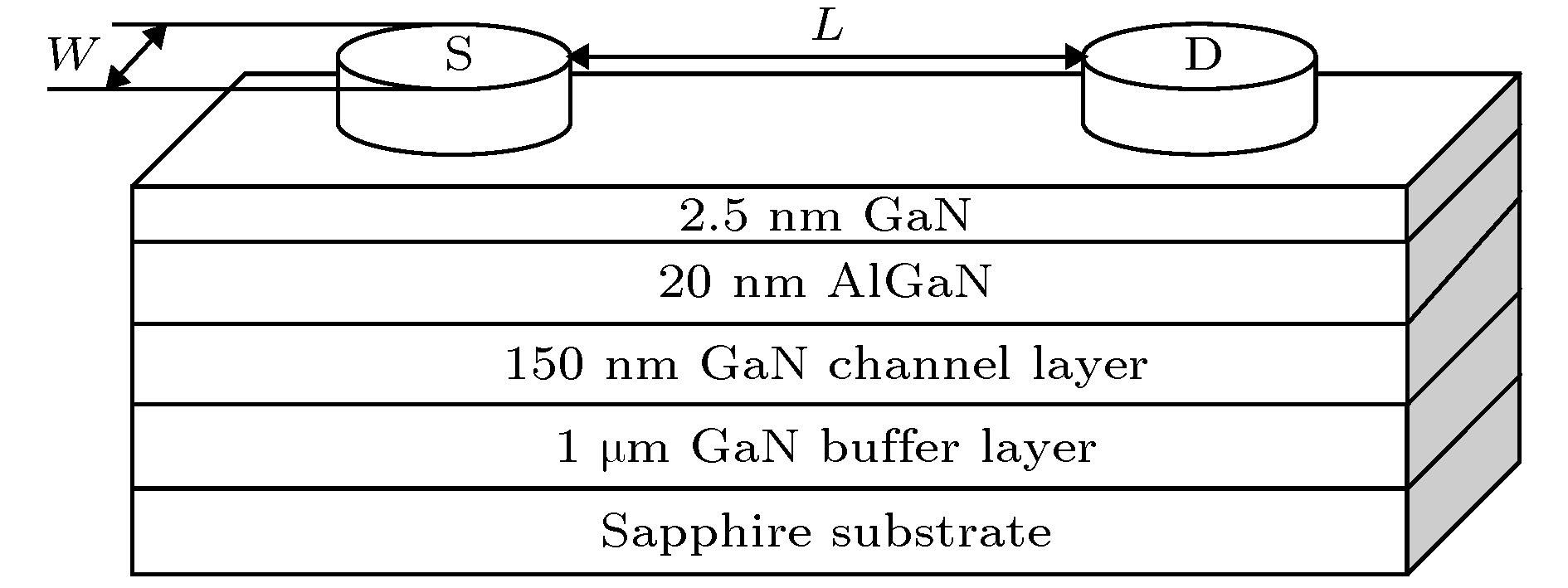
 下载:
下载: